隨著科技行業(yè)的持續(xù)關(guān)注,今年的驍龍峰會(huì)預(yù)計(jì)將于九月份提前舉行。作為高通年度最重要的活動(dòng),峰會(huì)不僅將揭曉下一代旗艦手機(jī)芯片,還將展示PC、音頻等領(lǐng)域的前沿芯片技術(shù),引領(lǐng)移動(dòng)智能領(lǐng)域的創(chuàng)新發(fā)展。
隨著峰會(huì)日期的臨近,有關(guān)下一代驍龍芯片的傳言逐漸增多,特別是備受矚目的驍龍X2 Elite。作為驍龍X系列的第二代產(chǎn)品,驍龍X2 Elite肩負(fù)著推動(dòng)Windows Arm PC市場(chǎng)發(fā)展的重任,其成功與否至關(guān)重要。
高通深知這一點(diǎn),因此從泄露的參數(shù)來(lái)看,驍龍X2 Elite與前代相比有著顯著的變化,堪稱一次全面的自我革新。其中,最引人注目的變化是采用了系統(tǒng)級(jí)封裝技術(shù),這一技術(shù)將極大地提升Arm PC的性能和靈活性。
去年,高通推出了第一代驍龍X系列芯片,標(biāo)志著驍龍?jiān)贏rm PC市場(chǎng)的突破性進(jìn)展。盡管性能與旗艦處理器相比還有一定差距,但其出色的能效表現(xiàn)使其成為輕薄本市場(chǎng)的熱門選擇。然而,對(duì)于PC用戶而言,性能始終是無(wú)法忽視的關(guān)鍵因素。MacBook在PC市場(chǎng)份額的持續(xù)增長(zhǎng),不僅得益于其出色的續(xù)航,更在于其性能與x86芯片相比毫不遜色。這也是Windows陣營(yíng)的Arm PC所面臨的一大挑戰(zhàn):如何在保持續(xù)航的同時(shí),提升性能以縮小與傳統(tǒng)x86芯片的差距。

驍龍X系列芯片采用單片系統(tǒng)級(jí)設(shè)計(jì)(SoC),雖然帶來(lái)了出色的能效表現(xiàn),但設(shè)計(jì)和制造成本較高,導(dǎo)致初期的驍龍PC價(jià)格昂貴,錯(cuò)失了中低端市場(chǎng)的最佳發(fā)展機(jī)遇。盡管后續(xù)通過(guò)優(yōu)化產(chǎn)品線結(jié)構(gòu)等方法降低了價(jià)格,但仍面臨設(shè)計(jì)靈活度不足和制造成本偏高的問(wèn)題。因此,轉(zhuǎn)向系統(tǒng)級(jí)封裝成為了必然選擇。與傳統(tǒng)SoC方案相比,系統(tǒng)級(jí)封裝可以根據(jù)需求靈活增減芯片,提供定制級(jí)產(chǎn)品,同時(shí)嚴(yán)格控制成本。系統(tǒng)級(jí)封裝下芯片之間的連接距離極短,可以顯著減少信號(hào)傳輸延遲,提高傳輸速率,并降低功耗。
蘋果在M1 Ultra上率先采用了系統(tǒng)級(jí)封裝技術(shù),讓兩顆M1 Max以極低的延遲互聯(lián),從而實(shí)現(xiàn)了性能的大幅提升。這一舉措讓許多人對(duì)Arm架構(gòu)的PC芯片有了全新的認(rèn)識(shí),證明了Arm架構(gòu)在高性能領(lǐng)域的潛力。因此,采用相同技術(shù)的驍龍X2 Elite也備受期待。
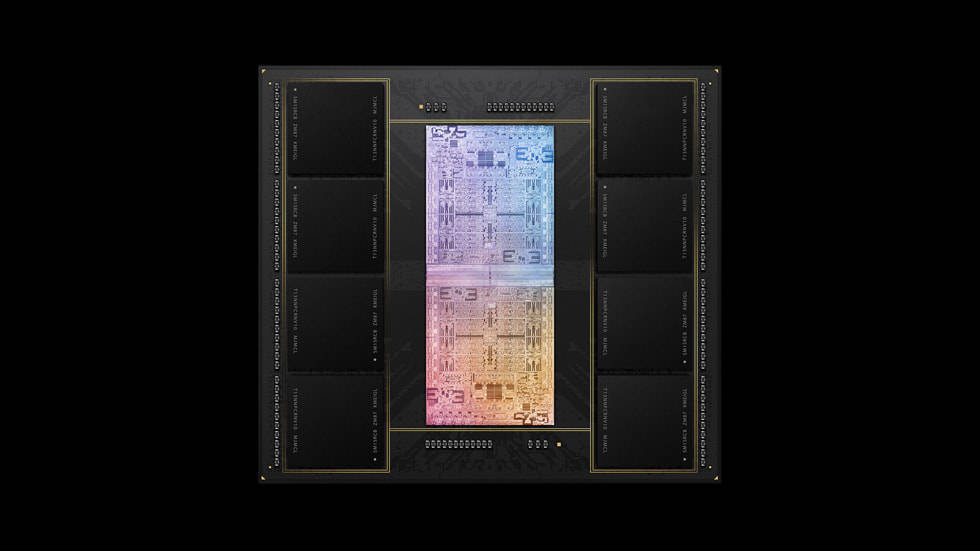
除了系統(tǒng)級(jí)封裝外,驍龍X2 Elite的核心數(shù)也大幅增加,從最高12核心提升至18核心,同時(shí)封裝的統(tǒng)一內(nèi)存最高可達(dá)64GB。這一變化使得驍龍X2 Elite在高端PC市場(chǎng)更具競(jìng)爭(zhēng)力。高通意識(shí)到,用戶對(duì)能效的需求存在邊際效應(yīng),當(dāng)PC續(xù)航超過(guò)一定時(shí)長(zhǎng)后,繼續(xù)增加續(xù)航并不會(huì)帶來(lái)顯著的體驗(yàn)提升。因此,驍龍X2 Elite在保持能效的同時(shí),更加注重性能的提升,以滿足用戶對(duì)復(fù)雜工作的需求。
與此同時(shí),PC市場(chǎng)已經(jīng)進(jìn)入存量競(jìng)爭(zhēng)階段,各大廠商都在尋求突破。AMD和英特爾等傳統(tǒng)廠商也在吸收Arm PC芯片的精髓,通過(guò)系統(tǒng)級(jí)封裝和先進(jìn)制程降低能耗,提升性能。例如,AMD的銳龍AI MAX+395采用系統(tǒng)級(jí)封裝,擁有16核32線程的CPU和RX 8060S GPU,最高支持128GB的統(tǒng)一內(nèi)存,成為唯一可以本地流暢運(yùn)行70B版DeepSeek模型的移動(dòng)端APU。

隨著系統(tǒng)級(jí)封裝技術(shù)的普及,未來(lái)PC市場(chǎng)的競(jìng)爭(zhēng)重心或?qū)⑥D(zhuǎn)向高性能APU的競(jìng)爭(zhēng)。Arm CPU的高能效特點(diǎn)在APU層面優(yōu)勢(shì)明顯,因?yàn)镚PU對(duì)功耗的要求極高,需要搭配的CPU具有更高的能效比。因此,使用系統(tǒng)級(jí)封裝技術(shù)將Arm CPU與高性能GPU整合為一塊芯片,并配上高規(guī)格的統(tǒng)一內(nèi)存,將成為未來(lái)Arm PC的主要發(fā)展方向。這樣的搭配不僅可以滿足游戲需求,還能更好地應(yīng)對(duì)AI方面的挑戰(zhàn)。

英偉達(dá)也推出了高性能的Arm架構(gòu)CPU,雖然功耗較高,但性能卓越。這一舉措進(jìn)一步證明了Arm架構(gòu)在高性能領(lǐng)域的潛力,也為未來(lái)Arm PC市場(chǎng)的競(jìng)爭(zhēng)增添了更多變數(shù)。




















